Sputtering devices specifications
CFS-4ES (Unit #1)

| Sputtering method | Side sputtering |
|---|---|
| Substrate heating | MAX300℃ |
| Substrate holder | Φ200mm |
| Reverse sputtering | Possible |
| Uniformity | ±10% (≦Φ150mm) |
| Reactive sputtering | Possible |
| Power supply | RF MAX 300W |
| Sputtering source | Magnetron 3sputtering sources |
| Ventilation system (Pump) Roughing vacuum |
Oil rotation |
| Ventilation system (Pump) Main vacuum |
Oil diffusion |
SRV-4300 (Unit #2)

| Sputtering method | Upward sputtering |
|---|---|
| Substrate heating | MAX300℃ |
| Substrate holder | Φ320mm |
| Reverse sputtering | Possible |
| Uniformity | ±10% (≦Φ220mm) |
| Reactive sputtering | Possible |
| Power supply | RF MAX 500W DC MAX 1kW |
| Sputtering source | Magnetron 3sputtering sources |
| Ventilation system (Pump) Roughing vacuum |
Oil rotation |
| Ventilation system (Pump) Main vacuum |
Oil diffusion |
SRV-4310 (Unit #3)

| Sputtering method | Upward sputtering |
|---|---|
| Substrate heating | MAX300℃ |
| Substrate holder | Φ320mm |
| Reverse sputtering | Possible |
| Uniformity | ±10% (≦Φ220mm) |
| Reactive sputtering | 可Possible |
| Power supply | RF MAX 500W DC MAX 1kW |
| Sputtering source | Magnetron 3sputtering sources |
| Ventilation system (Pump) Roughing vacuum |
Oil rotation |
| Ventilation system (Pump) Main vacuum |
Cryo |
CFS-12P-100 (Unit #4)

| Sputtering method | Upward sputtering |
|---|---|
| Substrate heating | MAX180℃ |
| Substrate holder | Φ396X4 stage Φ1000X1 stage |
| Reverse sputtering | Possible |
| Uniformity | ±10% (Need to be consulted for Φ1000mm stage) |
| Reactive sputtering | Possible |
| Power supply | DC MAX 2kW RF MAX 2kW |
| Sputtering source | Magnetron 3sputtering sources |
| Ventilation system (Pump) Roughing vacuum |
Oil rotation Mechanical booster |
| Ventilation system (Pump) Main vacuum |
Cryo |
SDH10311 (Unit #5)

| Sputtering method | Side sputtering |
|---|---|
| Substrate heating | Impossible |
| Substrate holder | Φ410X4 stage |
| Reverse sputtering | Possible |
| Uniformity | ±10% |
| Reactive sputtering | Possible |
| Power supply | DC MAX 4kW |
| Sputtering source | Magnetron 3sputtering sources |
| Ventilation system (Pump) Roughing vacuum |
Oil rotation Mechanical booster |
| Ventilation system (Pump) Main vacuum |
Cryo |
SRV-4320 (Unit #6)
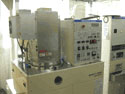
| Sputtering method | Upward sputtering |
|---|---|
| Substrate heating | MAX300℃ |
| Substrate holder | Φ320mm |
| Reverse sputtering | Possible |
| Uniformity | ±10% (≦Φ220mm) |
| Reactive sputtering | Possible |
| Power supply | RF MAX 500W DC MAX 1kW |
| Sputtering source | Magnetron 3sputtering sources |
| Ventilation system (Pump) Roughing vacuum |
Oil rotation |
| Ventilation system (Pump) Main vacuum |
TMP |
STV10321 (Unit #7)
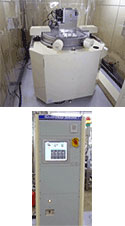
| Sputtering method | Upward sputtering |
|---|---|
| Substrate heating | MAX200℃ |
| Substrate holder | Φ410X4 stage Φ500X1 stage |
| Reverse sputtering | Possible |
| Uniformity | ±10% (Need to be consulted for Φ500mm stage) |
| Reactive sputtering | Possible |
| Power supply | DC MAX 4kW RF MAX 2kW |
| Sputtering source | Magnetron 3sputtering sources |
| Ventilation system (Pump) Roughing vacuum |
Oil rotation Mechanical booster |
| Ventilation system (Pump) Main vacuum |
TMP |
検索用入力欄
記入時注意事項
- テーブルの行列は変更しないでください。
- 分類が複数ある場合は、| ←半角の縦棒で区切って連続で入力してください。
また、区切り文字の前後に空白は入れないでください。
| 製品分類1 | Deposition, Photolithography, Etching |
|---|---|
| 製品分類2 | Insulation layer|Backside electrode|Li secondary battery|ITO|PZT|Roll to Roll sputtering |
| プロセス分類 | Prptotyping, R&D |
| サムネイル画像 |

|
| 説明文 |
|
| リダイレクトURL |
|
