エッチング装置仕様 / SEM写真
RIE

| 装置名 | EXAM |
|---|---|
| エッチング方式 | RIE (平行平板型、CCP) |
| 基板サイズ | Φ230mm以内 |
| 基板温度 | 20℃ |
| 電源 | 高周波 : 13.56MHz、max 500W |
| ガス種 | SF6、CF4、CHF3、O2、Ar |
| その他 | - |
ICP
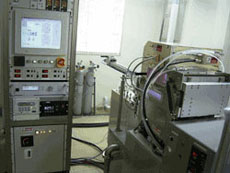
| 装置名 | SID-1246 |
|---|---|
| エッチング方式 | RIE (バイアス独立型、ICP) |
| 基板サイズ | Φ4インチ又は6インチ |
| 基板温度 | -10℃~40℃ |
| 電源 | 高周波 : 13.56MHz、max 2kW 低周波 : 460kHz、max 300W |
| ガス種 | SF6、CF4、CHF3、O2、Ar |
| その他 | 簡易ロードロック、静電チャック |
SEM画像
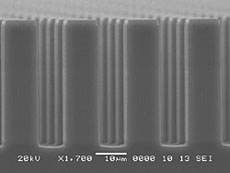
ICPによるSi加工例
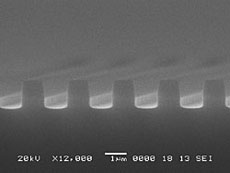
RIEによるSi加工例(上部レジスト付)
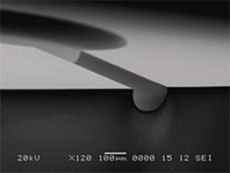
ウェットエッチングによるガラス加工例
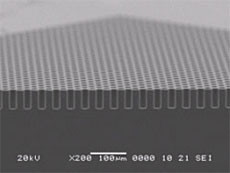
ICPによるSi加工例(お試しモールド)

酸化膜犠牲層エッチング加工例
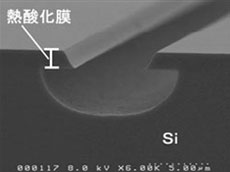
Si(シリコン)犠牲層エッチング加工例
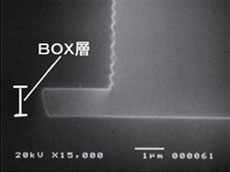
酸化膜犠牲層エッチング加工例加工断面
検索用入力欄
記入時注意事項
- テーブルの行列は変更しないでください。
- 分類が複数ある場合は、| ←半角の縦棒で区切って連続で入力してください。
また、区切り文字の前後に空白は入れないでください。
| 製品分類1 | 成膜・フォトリソ・エッチング |
|---|---|
| 製品分類2 | フォトリソ・エッチング |
| プロセス分類 | 試作・研究開発プロセス |
| サムネイル画像 |

|
| 説明文 |
|
| リダイレクトURL |
|
