パワーデバイス向け裏面電極成膜
ダイシング時チッピングが発生しないパワーデバイス向け裏面電極成膜
近年需要の高い IGBT や Diode といったパワーデバイス向けの裏面電極成膜を、試作から量産まで承ります。
特徴
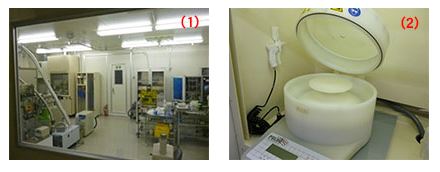
- クリーンルーム内作業(Class 1000)[写真(1)]
- DHFによる自然酸化膜除去(成膜加工直前に処理)[写真(2)]
- ダイシングのチッピング発生しない膜密着力を実現
- 薄厚ウェハへの対応(t=100µmの実績あり)
主な構造
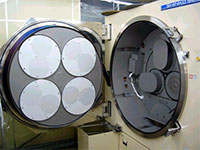
- Ti-Ni-Au
- Ti-Ni-Ag
- Al-1%Si etc.
このようなお客様に
- 裏面電極としての密着性やオーミックコンタクトの優れた膜が欲しい
- 裏面電極の膜構成や膜厚を変えた実験を行いたい
- 裏面電極の少量産の対応ができる委託先を探している
DHF洗浄試験(Si φ8”)
HF洗浄 条件検討項目
1. チャックによるウェハ損傷の有無
2. 裏面への薬液の回り込みの有無
3. HF洗浄効果の確認
1.チャックによるウェハ損傷の有無

| 使用装置 | Polos MCD300 [写真] |
|---|---|
| チャック 方式 | 薄膜ウェハー専用のチャック使用 |
| 確認Si ウェハ | 625µm厚、165µm厚、100µm厚 |
結果:3種厚さのSiウェハで、割れやクラックなどの発生は確認されなかった。
2.薬液裏面回り込みの有無
| 確認方法 | スピンしているウェハに超純水を滴下し、回転停止後、ウェハ裏面に水滴がついていないか確認 |
|---|---|
| スピン条件 | A)超純水:当社洗浄条件で実施し、裏面を確認 B)DHF :当社洗浄条件で実施し、裏面を確認 |
結果:A、B、A+Bの3条件とも、当社洗浄条件で実施。裏面への薬液回り込みは確認されなかった。
*厚さ違いのウェハにおいても同様
3.HF洗浄の効果の確認
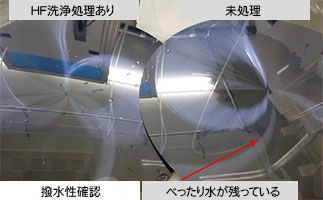
| 確認方法 | フッ酸洗浄の処理をしたウェハと、 未処理のウェハに 超純水を散布し、表面の撥水状態を確認する |
|---|---|
| 使用 ウェハ | 100µm厚と165µm厚のSiウェハ |
結果:HF洗浄有り=疎水性 HF洗浄無し=親水性
4.酸化膜除去測定
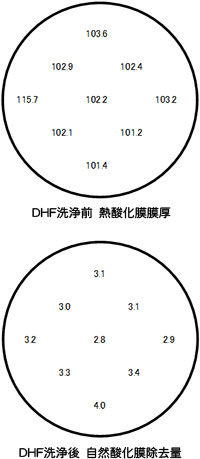
| 試験ウェハ | ・φ8"Siウェハ ・約100nm熱酸化膜付き ・ミラー面のみを洗浄 |
|---|---|
| 洗浄条件 | 当社条件 |
| 自然酸化膜除去量 | ・平均エッチング量 3.2nm ・最高エッチング量 4.0nm(最外周) ・最低エッチング量 2.8nm(中心) |
結果:一般的な自然酸化膜の膜厚定義:2.4nm、最低エッチング量2.8nm
以上の数値から、自然酸化膜は除去できたものと判断(要望により洗浄時間を追加することは可能)
検索用入力欄
記入時注意事項
- テーブルの行列は変更しないでください。
- 分類が複数ある場合は、| ←半角の縦棒で区切って連続で入力してください。
また、区切り文字の前後に空白は入れないでください。
| 製品分類1 | 成膜・フォトリソ・エッチング |
|---|---|
| 製品分類2 | 裏面電極 |
| プロセス分類 | 試作・研究開発プロセス |
| サムネイル画像 |  |
| 説明文 |
|
| リダイレクトURL |
|
